Sponsored content by RAFI Eltec GmbH
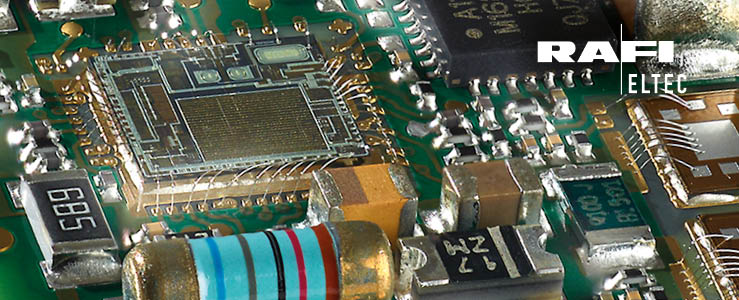
Chip-on-Board-Technologie Miniaturisierung in kleinste Dimensionen
Der Trend der Miniaturisierung
Die Miniaturisierung von Geräten und Systemen entwickelt sich permanent weiter. Dieser Trend führt
dazu das Computer, Mobiltelefone und medizinische Geräte immer kleiner, leichter und mobiler
werden und im Gegenzug immer mehr Funktionen integriert werden.
Große und schwere Geräte gehören aufgrund des Miniaturisierungstrends der Vergangenheit an. Die modernen Technologien ermöglichen es Geräte herzustellen, bei denen mehr Funktionen, auf zugleich immer kleinerem Raum integriert werden können. Die Miniaturisierung eröffnet Chancen in verschiedenen Bereichen und ermöglicht dadurch bessere Lebens- und Arbeitsbedingungen. Gerade in der InVitro-Diagnostic, in der Endoskopie, in der Elektrochirugie und bei der Patientenüberwachung werden Systeme im Miniaturformat verlangt. Auch bei Smartphones verändern sich die Anforderungen zu größeren Anzeigeflächen bei immer schlankerem Design, bei höherer Funktionalität und verbessertem Energieverbrauch. Das Hauptaugenmerk bleibt trotz des Miniaturisierungstrends bei der Qualität und Zuverlässigkeit des Gerätes. Zu den zentralen Faktoren, die den Fortschritt der Miniaturisierung fördern, zählt die rapide Verringerung der Größe von Halbleitern - der Hauptkomponente elektronischer Geräte.
Hier kommt die Chip-On-Board-Technologie ins Spiel.
Die Chip-on-Board-Technologie ist eine Arbeitsweise zur Direktmontage von nackten Silizium-Dies auf einer elektronischen Baugruppe unter Reinraumbedingungen. Bei der Platzierung von ungehäusten Halbleitern auf die Leiterplatte werden mit hochpräzisen Die-Bondern Bestückgenauigkeiten von ±10 µm (Winkelgenauigkeiten von ±15°) erreicht und mit einer funktionalen Klebetechnik dauerhaft verbunden. Die Halbleiter können von einem Wafflepack zugeführt oder direkt vom gesägten Wafer entnommen werden. Danach werden die Chip-Kontakte mit Gold- oder Aluminiumdraht mit den Leiterplattenpads verbunden. Beim Wire-Bonden handelt es sich um ein Ultraschall-Reibschweiß-Verfahren, bei dem der (17 um – 30 um dicke) Draht mit der Bondoberfläche eine Verbindung in der intermetallischen Zone eingeht. Dieser Prozess wird mit höchster Präzision und in einer enormen Geschwindigkeit durchgeführt, sodaß eine wirtschaftliche Produktion möglich ist. Die Prozesskontrolle erfolgt durch einen Abzugstest (Pull-Test), bei dem die Kraft gemessen wird, der die Bondverbindung standhält. Nach dem Bonden werden Chip und Drahtverbindungen von einem vollautomatisierten Präzisionsdispenser mit einer Epoxymasse (GlopTop) vergossen, bei Temperaturen über 100° C ausgehärtet und somit vor äußeren Umwelteinflüssen zuverlässig geschützt. Mit dieser Technologie ist eine zuverlässige Verbindungstechnik auf kleinstem Raum möglich. Aktuell wird bei RAFI Eltec an einem neuen Miniaturisierungs-Projekt gearbeitet, bei dem auf einer Leiterpatte, mit der Fläche von 2,8 mm x 2,5 mm mit COB- sowie SMD-Prozess kombiniert werden. Besonders in der Sensor-Technologie ermöglicht die COB-Technologie eine hohe Integrationsdichte auf kleinstem Volumen.
 Durch dieses Verfahren bieten sich viele Vorteile bezüglich Funktionalität, Qualität und Kosten.
a) Geringer Übergangswiderstand
Bei gehäusten Halbleitern werden die Bauteilpins mit dem Silizium-Chip verbunden, in dem standardmäßig ebenfalls eine Bondverbindung zwischen Halbleiter und Bauteilpin hergestellt wird. Die zweite Seite des Pins wird im Standardlötverfahren mit der Leiterplatte in Verbindung gebracht.
b) Geringere thermische Belastung
Temperaturkritische Halbleiter können schonend bestückt werden. Dabei wird zunächst die SMD-Bestückung durchgeführt. Der Chip wird dabei lediglich mit der Maximaltemperatur von 150°C, anstatt mit der Reflowprozesstemperatur von 250-260°C belastet. Die geringere thermische Belastung führt zu Qualitätserhöhungen und ermöglicht die problemlose Verarbeitung temperaturkritischer Bauteile
c) Geringer Platzbedarf
Um einen Chip in der Größe von 3x3mm zu bestücken, ist bei der Chip-On-Board-Technologie lediglich eine Fläche von 5x5mm notwendig. In der gehäusten Bauform (z.B. SOP24) ist bereits mehr als der doppelte Platzbedarf notwendig. Somit lässt sich mehr Funktionalität auf kleinerer Fläche unterbringen. Durch die Technologie Chip-On-Chip werden sogar zwei Halbleiter übereinander aufgebracht und verbunden. Der obere Halbleiter-Chip verschwendet keinen zusätzlichen Platz auf der Leiterplatte, wodurch die Bauteildichte pro Leiterplattenfläche gesteigert werden kann.
d) Bessere Wärmeableitung
Die Wärmeanbindung bei gehäusten Bauelementen wird in der Regel durch das Gehäuse deutlich verschlechtert. Beim Chip-On-Board-Prozess stellt ein Silberleitkleber die direkte Wärmebrücke von Silizium-Halbleiter auf die metallischen Oberflächen der Leiterplatte her. Diese Optimierung führt in der Regel zu Qualitäts- und Lebensdauererhöhung bei Systemen.
e) Preiswert
Besonders bei komplexen Halbleitern mit einer großen Verbindungsanzahl steckt in den Halbleiterpreisen ein hoher Kostenanteil für das Gehäuse. Durch das Verarbeiten des ungehäusten Siliziumchips lässt sich, trotz aufwändigerem Fertigungsprozess, eine Kostenersparnis erzielen.
Kontakt:
Tel.:+ 49 (0) 7551 / 8000-0
Durch dieses Verfahren bieten sich viele Vorteile bezüglich Funktionalität, Qualität und Kosten.
a) Geringer Übergangswiderstand
Bei gehäusten Halbleitern werden die Bauteilpins mit dem Silizium-Chip verbunden, in dem standardmäßig ebenfalls eine Bondverbindung zwischen Halbleiter und Bauteilpin hergestellt wird. Die zweite Seite des Pins wird im Standardlötverfahren mit der Leiterplatte in Verbindung gebracht.
b) Geringere thermische Belastung
Temperaturkritische Halbleiter können schonend bestückt werden. Dabei wird zunächst die SMD-Bestückung durchgeführt. Der Chip wird dabei lediglich mit der Maximaltemperatur von 150°C, anstatt mit der Reflowprozesstemperatur von 250-260°C belastet. Die geringere thermische Belastung führt zu Qualitätserhöhungen und ermöglicht die problemlose Verarbeitung temperaturkritischer Bauteile
c) Geringer Platzbedarf
Um einen Chip in der Größe von 3x3mm zu bestücken, ist bei der Chip-On-Board-Technologie lediglich eine Fläche von 5x5mm notwendig. In der gehäusten Bauform (z.B. SOP24) ist bereits mehr als der doppelte Platzbedarf notwendig. Somit lässt sich mehr Funktionalität auf kleinerer Fläche unterbringen. Durch die Technologie Chip-On-Chip werden sogar zwei Halbleiter übereinander aufgebracht und verbunden. Der obere Halbleiter-Chip verschwendet keinen zusätzlichen Platz auf der Leiterplatte, wodurch die Bauteildichte pro Leiterplattenfläche gesteigert werden kann.
d) Bessere Wärmeableitung
Die Wärmeanbindung bei gehäusten Bauelementen wird in der Regel durch das Gehäuse deutlich verschlechtert. Beim Chip-On-Board-Prozess stellt ein Silberleitkleber die direkte Wärmebrücke von Silizium-Halbleiter auf die metallischen Oberflächen der Leiterplatte her. Diese Optimierung führt in der Regel zu Qualitäts- und Lebensdauererhöhung bei Systemen.
e) Preiswert
Besonders bei komplexen Halbleitern mit einer großen Verbindungsanzahl steckt in den Halbleiterpreisen ein hoher Kostenanteil für das Gehäuse. Durch das Verarbeiten des ungehäusten Siliziumchips lässt sich, trotz aufwändigerem Fertigungsprozess, eine Kostenersparnis erzielen.
Kontakt:
Tel.:+ 49 (0) 7551 / 8000-0
 RAFI Eltec (damals noch Stephan Elektronik) investierte bereits 1994 in die Chip-On-Board-Technologie. Gezielt wurde Knowhow in den Technologien Chip on Board, Chip on Flex und Chip on Chip aufgebaut, um sich von den klassischen Baugruppenbestücker zu unterscheiden. RAFI Eltec konnte mehr als 25 Jahre Erfahrung in der Sondertechnologie Chip-On-Board (COB) sammeln und somit, sich als einer von wenigen COB-Dienstleitern in Deutschland, am Markt etablieren. Aus diesem Grund setzt RAFI Eltec weiter auf Chip-On-Board und akquiriert aktiv Neukunden mit anspruchsvollen Produkten von der Entwicklung bis hin zum kompletten Produkt.
RAFI Eltec (damals noch Stephan Elektronik) investierte bereits 1994 in die Chip-On-Board-Technologie. Gezielt wurde Knowhow in den Technologien Chip on Board, Chip on Flex und Chip on Chip aufgebaut, um sich von den klassischen Baugruppenbestücker zu unterscheiden. RAFI Eltec konnte mehr als 25 Jahre Erfahrung in der Sondertechnologie Chip-On-Board (COB) sammeln und somit, sich als einer von wenigen COB-Dienstleitern in Deutschland, am Markt etablieren. Aus diesem Grund setzt RAFI Eltec weiter auf Chip-On-Board und akquiriert aktiv Neukunden mit anspruchsvollen Produkten von der Entwicklung bis hin zum kompletten Produkt.




